方案简介
Program overview

晶圆划片是半导体芯片制造工艺流程中的一道必不可少的工序,在晶圆制造中属后道工序。
将做好芯片的整片晶圆按芯片大小分割成单一的芯片(晶粒),称之为晶圆划片。
近年来光电产业的快速发展。高集成度和高性能的半导体晶圆划片需求不断增长。
硅、碳化硅、蓝宝石、玻璃以及磷化铟等材料被广泛应用于半导体晶圆的衬底材料。
随着晶圆集成度大幅提高,晶圆趋向于轻薄化,传统的很多加工方式已不再适用。于是部分工序引入了激光隐形切割技术。
方案推荐
半导体晶圆的激光隐形切割技术是一种全新的激光切割工艺,其主要原理是将短脉冲激光光束透过材料表面聚焦在材料中间,在材料中间形成改质层,然后通过外部施加压力使芯片分开。
-

激光剥线机
精度高、速度快、寿命长、运行平稳
加工时与线材不接触,没有加工应力
剥线更干净、没有残留、操作更容易
-
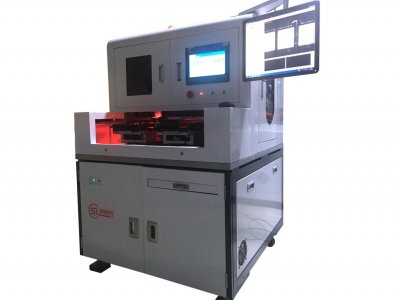
激光锡球焊
CCD定位系统,满足高精密器件要求
无任何应力接触,极大削弱了热效应
不需助焊剂、无污染,保证器件寿命
-
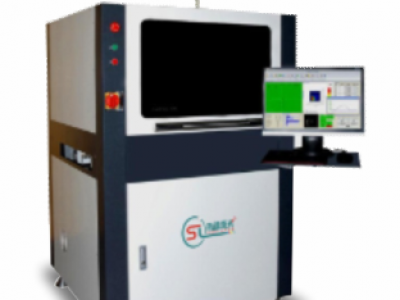
锡丝激光焊接机
-

晶圆激光隐割机
-
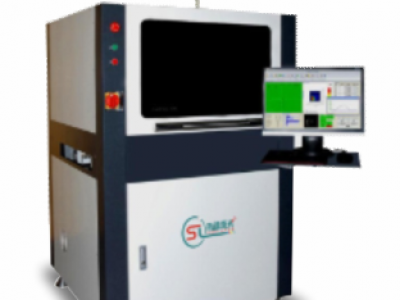
锡膏激光焊接机
-

SiC/Si晶圆激光隐切设备
-

准直式焊接机
选配CCD摄像监视系统,更方便观察
焊斑能量分布均匀,具有合适的光斑
适应各种复杂焊缝,各种器件的点焊
-

脆性材料精密切割机(化合物材料)
-

PCB板在线激光打码机
用于印制线路板上镭雕条码,二维码等
自动定位打码,基本无耗材、永久标记
可在任意位置或元器件赋码、稳定可靠
-

QCW激光焊接机
主要针对薄壁材料、精密零件的焊接
整机性能稳定、功耗低、使用寿命长
对焊接难以接近的部位可高精度定位
-

全自动芯片切割机
-

电池盖帽光纤激光焊接机
-

全自动激光精密切割机
光束质量好、聚焦光斑小、热效应小
自动定位,自动涨缩补偿,操作方便
切割表面光滑无毛刺碳化、增加产量
-

PVD油墨清除
工作寿命长达5万个小时,稳定性更强
体积小、且重量轻、安装使用更加灵活
清除油墨PVD镀膜透光率可达90%以上
-
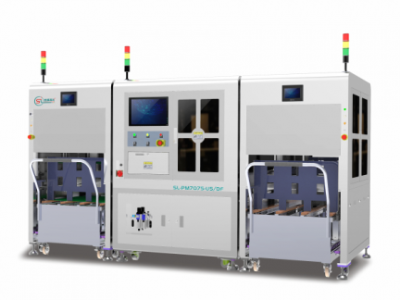
PCB大幅面打码机
-

IC芯片激光开封机
-

光纤陶瓷切割机
-

FPC激光打码机
高平均功率和高重重频率,打标速度快
激光光斑输出极小,光模式好、功耗低
适用于精细图文等要求很高的场合标记
-

电池盖帽YAG激光焊接机
选配CCD摄像监视系统,更方便观察
适应各种复杂焊缝,各种器件的点焊
可实现多光束在时间和能量上的分光
-

在线激光打标机
永不可擦涂、具较强的防伪防窜货特性
可打标产品日期和各种批号等标记内容
提高生产效率,适应工业生产的高要求
-

玻璃打孔机
-

晶圆ID激光打标机
-

精密金属板材激光切割机
精度高、稳定性好、切割断面质量好
幅面大、适应切割材料多、性价比高
切割速度快、效益高、使用成本低廉
-

精密陶瓷激光切割机
高品质进口光纤激光器或者CO2激光器
Sholaser Cutting Software专用软件
专用光束传输系统,定位准、稳定性高
-

CCS模组纳秒激光焊接机
采用扫描焊接方式,熔深大,热效应小
自主开发同轴视觉定位系统,拓展性强
激光能量按指定轨迹均匀分布节约成本
-

便携式激光打标机
具备高速度、高质量、高性价比的特性
电光转换率高,体积小,运行成本较低
价格实惠,性价比极高,投入成本低廉
-
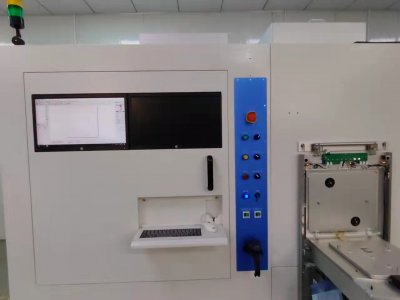
Wafer Backside 激光打码机
-

IC载板激光打码X-OUT设备
-

框架2D码激光刻字机
-

蓝宝石形貌检查设备
SL-F3000可以测量直径 60~300mm(3~12in)的各类晶体材 料(硅、玻璃、蓝宝石等)的翘曲度、弯曲度、厚度(透明)等,能够 消除重力的变形影响,获取材料真实 的表面参数,对3DIC集成至关重要。
常规的测量方法为按照一定标准水平 放置,测量得到的结果为重力变形后 的结果。 SL-F3000采用竖
直放置法,利用 材料的面内刚度大,大幅度降低重力 的影响。针对12in厚0.3mm的这种大 而薄的晶圆,
也能达到很高的精度。 消除重力变形影响,精准测量 表面各项平面度及厚度参数。
-
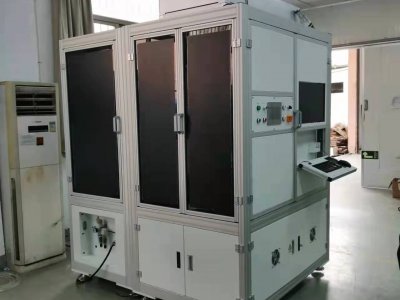
蓝宝石晶圆外观检查设备
主要针对蓝宝石晶圆的崩边、划伤、刀纹、污渍等外观缺陷的视觉检测
-

玻璃激光切割机
-

HTCC/LTCC膜材激光打孔切割设备
-

FPC软板全自动打码机
-

FPC覆盖膜激光切割机/卷对片(卷对卷)切割机
-

皮秒紫外精细微加工设备
-

紫外激光切割机
-

FPC laser coding machine
高平均功率和高重重频率,打标速度快
激光光斑输出极小,光模式好、功耗低
适用于精细图文等要求很高的场合标记
-

PCB automatic laser printer
高速振镜、加工精度高、打标速度快
自动获取工单号等实现自动打码功能
无耗材产生、环保、无污染、免维护
-

Laser wire stripper
精度高、速度快、寿命长、运行平稳
加工时与线材不接触,没有加工应力
剥线更干净、没有残留、操作更容易
-

Laser cleaner
对基片产生的热负荷和机械负荷极小
废物可回收,无环境污染、安全可靠
清除各种不同厚度、不同成份的涂层
-

PCB large surface coding machine
高性能进口激光器光束好,刻印质量好
CCD高精准自动定位、检测、读码评级
Mark点识别定位,保证高精度打标要求
-

PVD ink removal
工作寿命长达5万个小时,稳定性更强
体积小、且重量轻、安装使用更加灵活
清除油墨PVD镀膜透光率可达90%以上
-

PCB board on-line laser printer
用于印制线路板上镭雕条码,二维码等
自动定位打码,基本无耗材、永久标记
可在任意位置或元器件赋码、稳定可靠
-

Fiber optic laser cutting machine
高精密直线电机工作台,精度高速度快
专用光束传输系统,定位高且稳定性高
CCD自动定位校正,完美补偿材料涨锁
-

Fully automatic laser precision cutting machine
光束质量好、聚焦光斑小、热效应小
自动定位,自动涨缩补偿,操作方便
切割表面光滑无毛刺碳化、增加产量
-

CO2 laser cutting machine
-

Large surface laser cutting machine
精度高、稳定性好、切割断面质量好
幅面大、适应切割材料多、性价比高
切割速度快、效益高、使用成本低廉
-

Precision ceramic laser cutting machine
高品质进口光纤激光器或者CO2激光器
Sholaser Cutting Software专用软件
专用光束传输系统,定位准、稳定性高
-

Picosecond laser cutting machine
切割速度快、品质高、大幅提高产能
设备无需任何耗材,使用成本明显低
支持多种视觉定位特征、断面无锥度
-

FPC laser precision cutting machine
切割表面光滑无毛刺无碳化、无崩边
无接触无应力加工,增产、降低成本
操作简单方便,一次定位,一次完成
-

Galvanometer welding machine
适用各种小型薄壁零部件的激光精密点焊
焊接点或图形可在软件中直接输入、编辑
质量稳定、操作方便、维护简单、成本低
-

QCW laser welding machine
主要针对薄壁材料、精密零件的焊接
整机性能稳定、功耗低、使用寿命长
对焊接难以接近的部位可高精度定位
-

Optical fiber transmission laser welding machine
选配CCD摄像监视系统,更方便观察
适应各种复杂焊缝,各种器件的点焊
可实现多光束在时间和能量上的分光
-

Collimating welding machine
选配CCD摄像监视系统,更方便观察
焊斑能量分布均匀,具有合适的光斑
适应各种复杂焊缝,各种器件的点焊
-

Nanosecond laser welding machine
采用扫描焊接方式,熔深大,热效应小
自主开发同轴视觉定位系统,拓展性强
激光能量按指定轨迹均匀分布节约成本
-
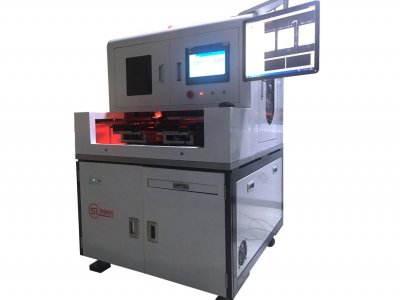
Laser solder ball welding
CCD定位系统,满足高精密器件要求
无任何应力接触,极大削弱了热效应
不需助焊剂、无污染,保证器件寿命
-

Continuous fiber laser welding machine
焊接速度快,焊缝牢固美观,高效完美
电光转换率高、能耗低,节省加工成本
设备可靠性高,可24小时连续稳定加工
-

Green laser marking machine
打标过程为非接触式,打标效果永久性
电光转换速率极高,输出激光能量稳定
光束质量高,线条精细,标刻清晰易记
-

Optical fiber laser marking machine
可靠性极高,输出光速质量好,适应强
电光转换效率高,加工速度快,免维护
可对多种材质进行多样化标记,多选择
-

Co2 laser marking machine
-

Portable laser marking machine
具备高速度、高质量、高性价比的特性
电光转换率高,体积小,运行成本较低
价格实惠,性价比极高,投入成本低廉
-

On-line laser marking machine
-

Ultraviolet laser marking machine
激光光斑输出极小,适用精细图文标记
激光光束质量好,输出激光机稳定性高
电光转换效率高,速度快,使用寿命长
-

6040精密光纤激光切割机
高精密直线电机工作台,精度高速度快
专用光束传输系统,定位高且稳定性高
CCD自动定位校正,完美补偿材料涨锁
-

激光清洗机
对基片产生的热负荷和机械负荷极小
废物可回收,无环境污染、安全可靠
清除各种不同厚度、不同成份的涂层
-

PCB大幅面打码机
高性能进口激光器光束好,刻印质量好
CCD高精准自动定位、检测、读码评级
Mark点识别定位,保证高精度打标要求
-

CO2激光切割机
切割过程不烧焦不发黄,使用寿命更长
设备整体结构稳重牢固,结构为封闭式
配备高精度速度丝杆导轨传动伺服系统
-

皮秒激光切割机
切割速度快、品质高、大幅提高产能
设备无需任何耗材,使用成本明显低
支持多种视觉定位特征、断面无锥度
-

FPC激光精密切割机
切割表面光滑无毛刺无碳化、无崩边
无接触无应力加工,增产、降低成本
操作简单方便,一次定位,一次完成
-

振镜焊接机
适用各种小型薄壁零部件的激光精密点焊
焊接点或图形可在软件中直接输入、编辑
质量稳定、操作方便、维护简单、成本低
-

IC芯片全自动打码机
-

紫外激光打标机
激光光斑输出极小,适用精细图文标记
激光光束质量好,输出激光机稳定性高
电光转换效率高,速度快,使用寿命长
-

电池防爆阀激光焊接机
焊接速度快,焊缝牢固美观,高效完美
电光转换率高、能耗低,节省加工成本
设备可靠性高,可24小时连续稳定加工
成本分析
cost analysis
采用皮秒激光器、定制聚焦头, 聚焦光束直径小到3μm,切割道仅需10μm,切缝窄,更多的芯片出片率,无热效应,对芯片电路无损伤。
划片速度高达500mm/s, 对于厚度1mm内样品,激光划线仅需一次即可折断。
CCD视觉预扫描&自动抓靶定位、最大加工范围650mm×450mm、XY平台拼接精度≤±3μm。
无锥度切割、最小崩边3μm, 边缘光滑。支持多种视觉定位特征,如十字、实心圆、空心圆、L型直角边、影像特征点等。



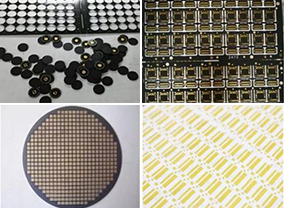











 江苏总部:江苏省昆山市巴城镇东定路600号
江苏总部:江苏省昆山市巴城镇东定路600号